编者按:介绍另一种2纳米EUV光刻胶--泛林的干式光刻胶研发进展。这是在IMEC采用ASML的NXE:3400B光刻机上进行的曝光测试。

ASML的NXE:3400B光刻机
前两篇文章里,我们讨论了美国初创企业Inpria的2纳米EUV光刻胶技术。目前在2纳米EUV光刻胶领域,还有一项类似的基于纳米核抗蚀剂的光刻胶技术--美国泛林(Lam Research)的干式光刻胶(Dry resist)。
2023年的高级光刻和图案化国际会议上,泛林和合作方比利时IMEC报道了用于高数值孔径EUV光刻的2纳米光刻胶的进展,我们一起来看一下。

2纳米光刻胶实测的硬件
泛林的EUV光刻胶采用的是干式曝光,采用的是LAM的显影设备。
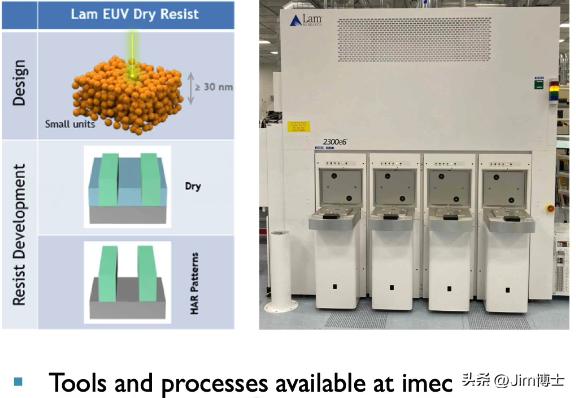
由于0.55NA EUV光刻机还没有制造出来,为了评估2纳米光刻胶,IMEC通过改造0.33 NA EUV光刻机NXE:3400B的光瞳来增加对比度,来实现24纳米间距的精度(12纳米分辨率)。

2纳米光刻胶实测的规划
在IMEC的逻辑芯片节点线路图中,对于2纳米以下工艺的参数要求:
M2金属间距24纳米,Tip-to-Tip(T2T)间距15纳米,M2/M3金属层通孔(Via)36纳米。

对于2纳米光刻胶的测试分三个阶段:
1,采用一般的一维结构,如光栅结构或规则接触孔或柱结构,进行光刻胶的遴选。这就是前两篇我们讨论的MOR光刻胶里面的大量测试L/S分辨率就属于第一层级。
当光刻胶通过第一阶段的分辨率遴选后,才会进入第二阶段。
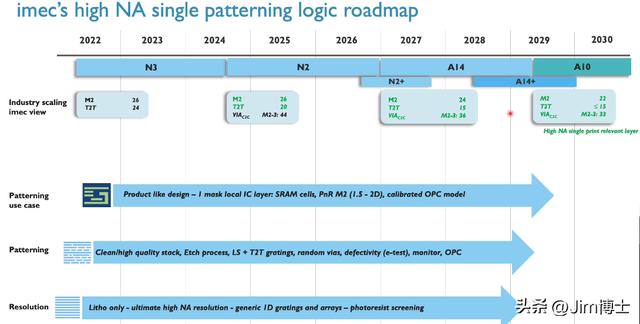
2,第二阶段是图案化测试,要将模式转移到堆栈中来对缺陷进行评估,同时监测工艺过程的稳定性。这个阶段需要测试Tip-to-Tip结构,因此开始引入光学邻近效应修正OPC。
3,第三阶段是产品图案化测试,采用接近产品设计的图案进行测试,这里OPC模型的标定在这里起着至关重要的作用。
通常,每个阶段至少需要两年的时间。这就是说,为导入一款新的2纳米EUV光刻胶需要6年的评估时间。

2纳米光刻胶实测流程
这是测试2纳米光刻机的24纳米L/S图形的流程。

评估方式是通过CD-SEM采集每个流程的50张电子显微镜照片,并用软件提取LER、LWR参数,以及曲线、桥接缺陷数量。
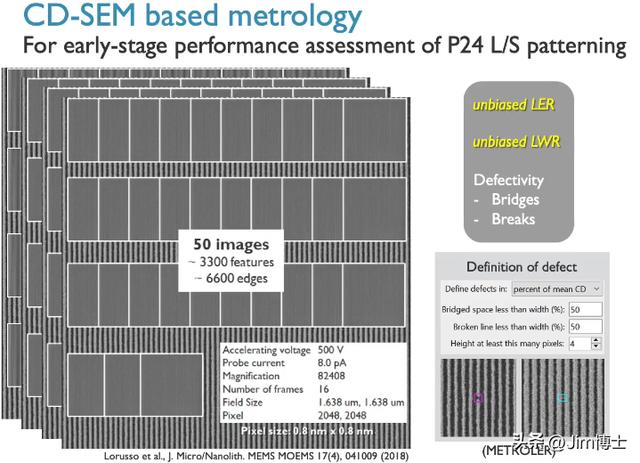
IMEC引入了无故障纬度(FFL)来衡量光刻胶工艺过程的鲁棒性。FFL是考察同一个工艺下制造不同线宽的缺陷数量。FFL窗口越宽,说明这个过程就越可靠。
光刻胶工艺流程的优化,就是在减少剂量、减少粗糙度和z因子的同时,增加FFL。
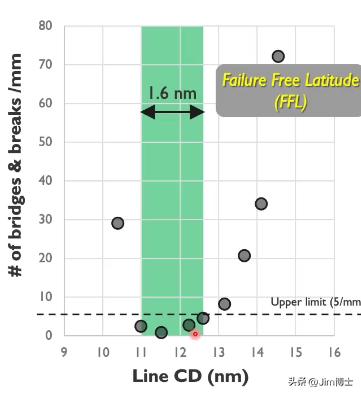
2纳米光刻胶的工艺流程优化:第一阶段
接下来就是大量的工艺优化数据和数据处理。首先是曝光温度、时间、剂量的优化。
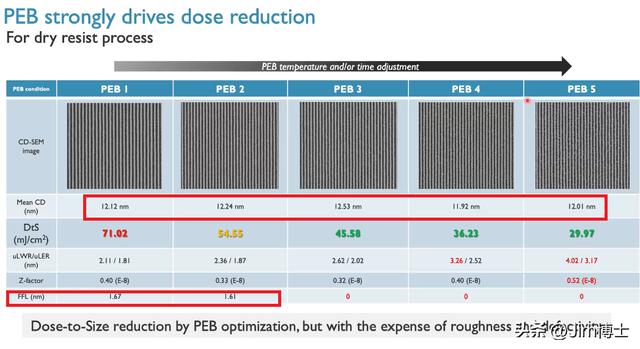
对不同曝光工艺条件下的缺陷密度的分析。

接下来对显影过程的优化。可以看到下图DD4获得的一个优化工艺窗口,其中FFL高达3.88纳米。
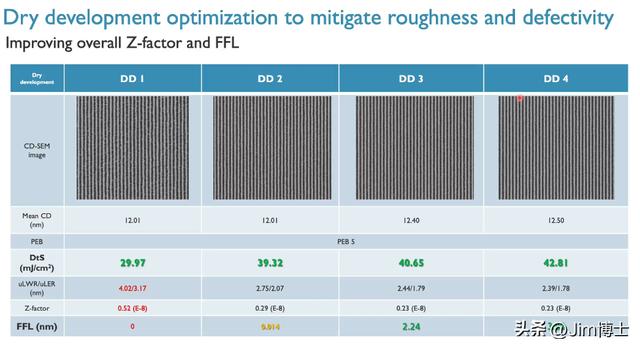
对不同工艺流程下全部的曝光指标进行分析。

接下来进行了图形转移测试和指标优化。

下图展示了一个流程优化的效果,它将曝光剂量从70降低到57,同时FFL窗口从0纳米增加到3.1纳米。
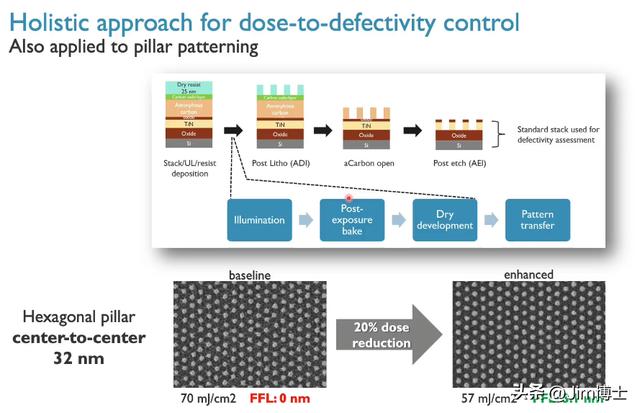
结语
目前IMEC和泛林团队对于2纳米干式EUV光刻胶的测试完成了第一个一维图形分辨率测试阶段,即将进入到第二个阶段的图形化测试。
从上述资料我们可以看到,2纳米EUV光刻胶的测试需要材料制造商、设备制造商、芯片工艺开发商等的协作外,这项工作本身并不是非常复杂或者高深,但是它需要基本的高分辨EUV光刻机的硬件条件,以及漫长的测试流程。
结合前几篇资料,我们可以了解,国外在搭建基本的EUV光刻胶技术上投入了非常多的机构、人力、物力资源以及十几年的积累。而我们目前连这些基本设施还没有具备。这就是真正被卡的地方。我们下节继续!
 鲁公网安备37020202000738号
鲁公网安备37020202000738号