编者按:基于2纳米EUV光刻光学框架,对0.2纳米EUV光刻光学进行模拟研究,对关键调整技术例如采用非等间距的多层反射膜、下一代的掩模版吸收材料、偏光片降低偏振光极化效应等进行论证。
前篇我们谈了超数值孔径(0.75NA)EUV光刻机,它可能是2040年代的半导体工业驱动器。由于EUV光刻机的型号和代数特别多,很多网友容易误解,所以我就粗略地把“0.75NA”超数值孔径EUV光刻机称作“0.2纳米EUV光刻机”;同样,我们可以把“0.55NA”的高数值孔径EUV光刻机称作“2纳米EUV光刻机”;把“0.33NA”第一代EUV光刻机称作“7纳米EUV光刻机”,以便大家阅读。

我们这么区分EUV光刻机的代数,是和目前的芯片制程的定义吻合的:
1,2纳米EUV光刻机将在2024年2纳米芯片制程(N2)以下成为主导生产力工具。
2,0.2纳米EUV光刻机将在2036年后的2埃芯片制程(A2)以下称为主导生产力工具。
当然,这里的预期是A2芯片制程到达极限时,还有望通过结构的尺寸进行缩放,关于这个话题,我们后面再聊。

接下来我们就看一下IMEC的0.75NA EUV光刻光学的预研是怎么做的。
1,首先要强调的是,目前的预研是模拟工作,使用的是Synopsys的3D掩模版模拟器S-litho EUV进行的。模拟的光学系统仍然采用0.55NA光学系统的非对称结构,也就是X方向缩放4倍,Y方向缩放8倍。

2,通过模拟器优化0.75NA的照明模块参数。

3,优化EUV掩模版的反射率。这里同时引入更高数值孔径的0.85NA光学进行同步计算。从初步的测算可以看到,0.75NA光学系统下,EUV反射率的反射角范围已经超出0.33NA的反射膜的反射角,因此需要重新设计。
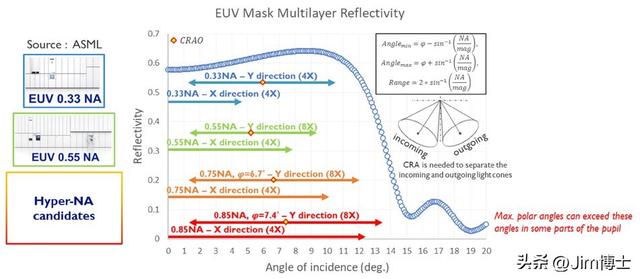
4,优化的方向是调整EUV反射镜多层膜的间距,来扩大入射角范围。通过模拟多层膜反射率(ML Reflectivity)的入射角度,我们可以看到,反射率曲线在1.000-1.012的多层膜间距放大倍率下,可用的入射角范围可以从12度提高到14度。
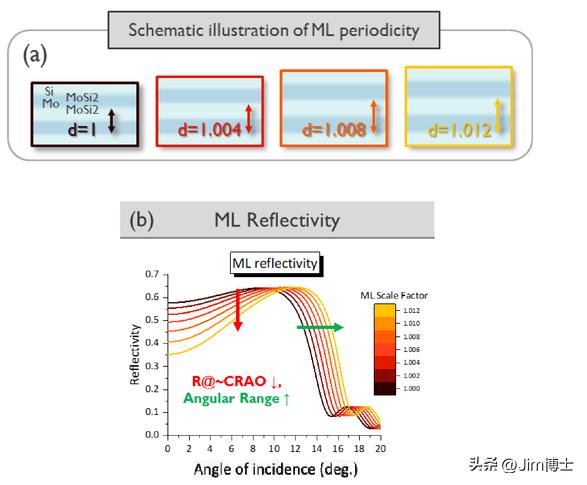
5,利用上述掩模版的EUV反射率曲线,对0.75NA和0.85NA光学模块进行成像分析。
从下图可以看到,对于075NA光学,在L/S间距12纳米(也就是分辨率6纳米)的条件下,系统成像能力不会随反射膜间距调整产生显著变化,因此可以初步判断,目前的0.55NA反射镜镀膜方案基本可以延续到0.75NA。
但是对于0.85NA光学成像,在L/S间距10.48纳米(也就是分辨率5.25纳米)的条件下,系统成像能力随反射膜间距调整产生显著变化。因此,如果要使用0.85NA光学,目前的EUV反射镜镀膜方案需要调整。一个可能的方案是采用非等间距EUV反射膜。
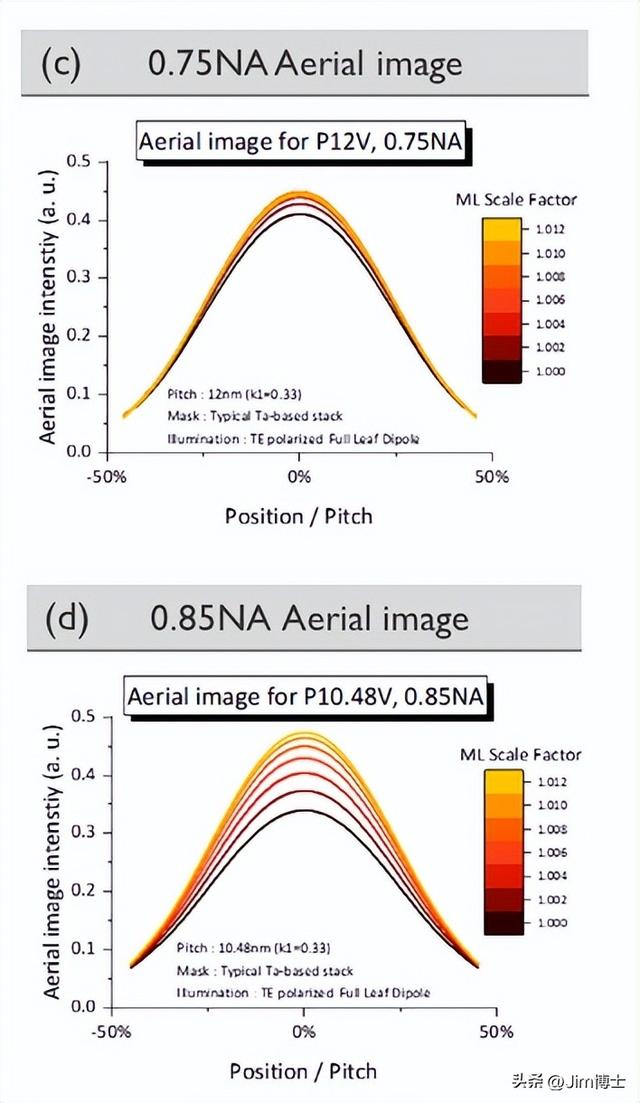
6,优化掩模版的吸收层的材质,考察折射率n和消光系数k、吸收材料的分布和厚度对掩模版3D效应的影响。
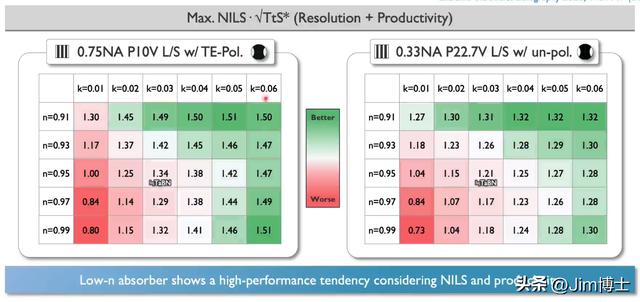
初步判断,目前正在为0.33NA和0.55NA系统开发的新型低n空间掩模吸收材料足以支持0.75NA性能。
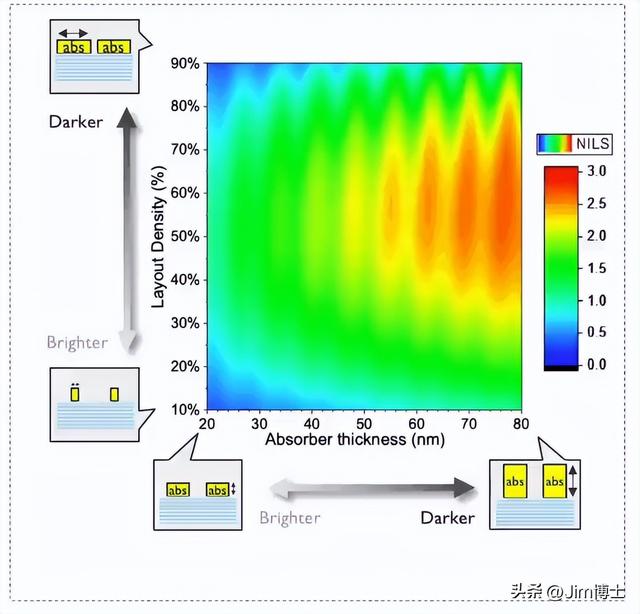
7,考察EUV光的偏振光极化效应导致的分辨率降低问题。


对于EUV而言,由于EUV光刻胶折射系数只有DUV光刻胶的一半,其入射角是DUV的2倍,因此其极化效应更强。
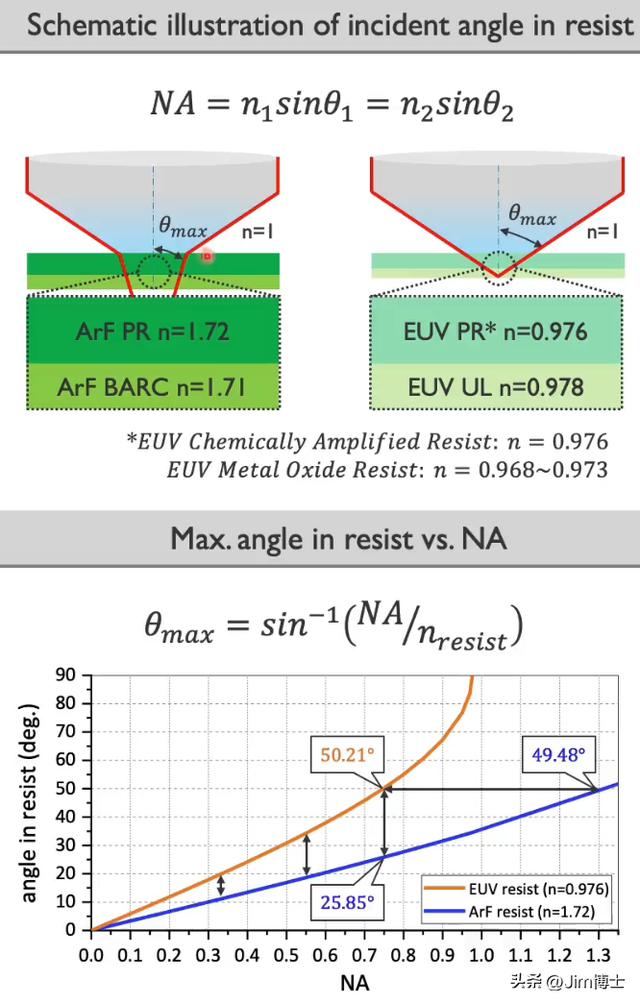
对于0.75EUV光学,在20纳米L/S间距以下(分辨率10纳米以下),极化效应已经较为严重。


作者考虑了采用偏光片降低极化效应。

同样考察了极化效应对C/H阵列图案的影响,照明系统对极化效应影响显著。

使用偏光片虽然降低EUV入射光强,但是有可能在低L/S间距时降低误差。
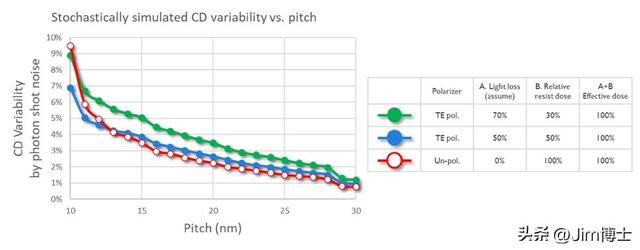
作者认为,降低EUV光的偏振极化效应,将是0.75NA光刻机的最大挑战。

通过初步的浏览,我们可以了解IMEC的0.2纳米EUV光刻机的预研工作,是在过去十年的EUV光刻机的成熟的技术体系下,对获得0.2纳米EUV光刻机的光刻分辨率极限的重要约束条件进行了初步的模拟,并且在此技术上,指出了在各个重要环节上为实现0.2纳米EUV光刻机所需要进行调整的技术,例如采用非等间距的多层反射膜、下一代的掩模版吸收材料、偏光片降低偏振光极化效应等。相信不久我们就可以看到这部分后续工作。
 鲁公网安备37020202000738号
鲁公网安备37020202000738号