编者按:2纳米芯片即将进入公众视野,2纳米EUV光刻机也即将发货,金属氧化物抗试剂MOR被认为是最有希望的2纳米EUV光刻胶。
在前几篇帖子里,我们已经大概了解了目前的2纳米EUV光刻机(0.55NA)的光源和光学制造,并且提到了0.2纳米EUV光刻机(0.75NA)的预研工作。接下来,我准备花3-4篇文章介绍一下2纳米EUV光刻胶的进展。
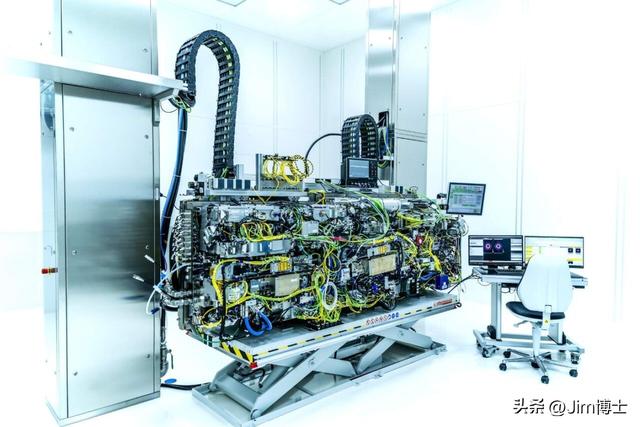
目前的2纳米EUV光刻胶的主要方向有2个,第一个是采用7纳米EUV光刻机的化学扩增抗蚀剂(CAR),第二个是采用创新的金属氧化物抗蚀剂(MOR)。

要进行EUV光刻胶的研制,首先需要匹配的高分辨EUV光源。目前具备高分辨EUV光刻机研究的单位寥寥无几,其中主要的除了拥有EUV光刻机的单位,其他机构包括拥有高分辨EUV曝光机(MET-5)的美国劳伦斯伯克利国家实验室,以及拥有高分辨EUV干涉光刻的瑞士保罗·谢勒研究所(Paul Scherrer Institude,PSI)。这两家机构采用的都是同步辐射。比利时IMEC既有ASML的7纳米EUV光刻机,也有一套基于美国高谐波生成相干光源的双干涉光刻装置。
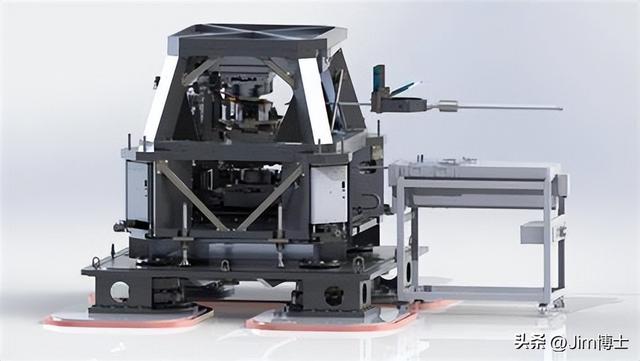
美国劳伦斯伯克利国家实验室高分辨EUV曝光机(MET-5)
保罗·谢勒研究所与ASML有长期合作框架,几乎每年都会在各种光刻会议上报告EUV光刻胶的研究工作。今天我们介绍的2023年4月在加州SPIE会议上公布的2022年下半年的研究结果。

保罗·谢勒研究所的EUV干涉光刻安装在瑞士同步辐射光源(Swiss Light Source)上(下图左上角就是瑞士光源)。这个实验室从事EUV光刻胶的研究已经超过十年历史了,可以说是伴随着EUV光刻技术的大规模商业化同步成长的。

干涉光刻利用同步辐射的两束相干光源的狭缝衍射效应成像。

利用不同的狭缝图形,可以完成规整的L/S图形或者点阵图形曝光,达到极高的分辨率。
根据网站更新的资料,保罗·谢勒研究所目前可以实现的EUV光刻分辨率是6纳米(12 纳米L/S间距)。

EUV光刻胶的评估方案是用SEM显微镜拍照,并用图像处理软件对照片提取线宽或半间距(HP)、线宽粗糙度(LWR)等数据。
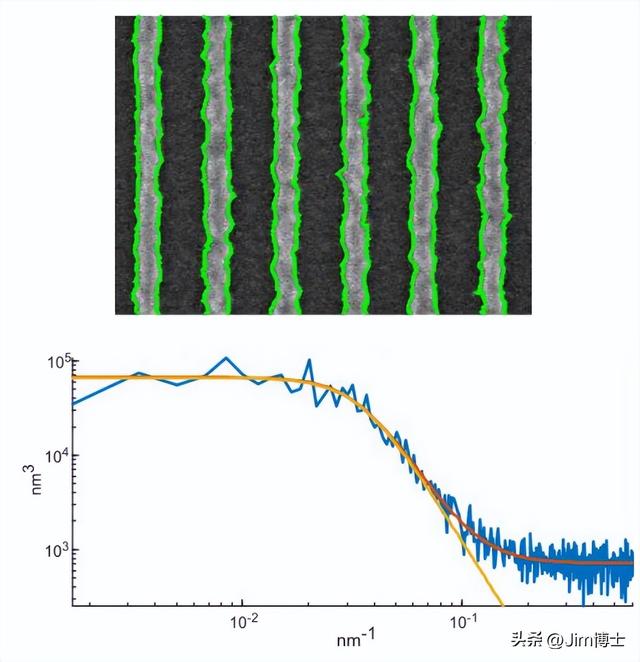
在半年时间,PSI小组研究了来自6个供应商的100个EUV光刻胶样品。通常16纳米的分辨率适用于7-5纳米芯片节点,13纳米分辨率适用于5-3纳米芯片节点。对于2纳米芯片,研究聚焦于12纳米以下分辨率。
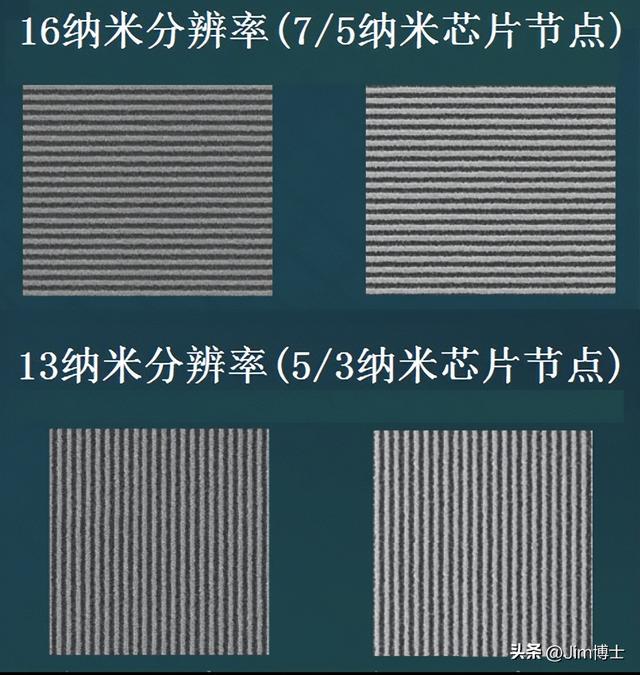
接下来我们看一下最佳的研究结果:
1,作为对比,下图展示的是4款光刻胶在14纳米半间距(HP)下的曝光图案SEM照片,大致来说,这是7纳米光刻机的工作区间。可以看到,这四款的曝光效果都很好。

2,但是当曝光的半间距从14纳米缩小到13纳米的时候,我们可以看得很清楚,其中3款CAR光刻胶曝光效果非常完整清晰,而对照组的C样品MTP光刻胶效果就非常差,不仅线条边缘不规则,而且出现大量的桥接。
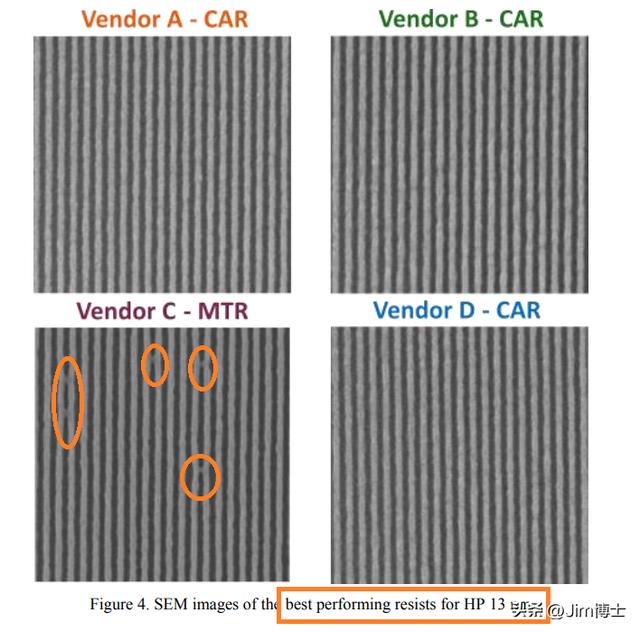
3,接下来我们看一下曝光半间距降低到12、11、10纳米的情况,首先,第三组的MRT光刻胶线条已经发生断裂;第四组的CAR光刻胶线条也开始发生桥接。
A组的CAR光刻机在12纳米曝光线条良好,而B组CAR光刻胶一直到11纳米仍然保持线条完好。
因此,最好的CAR光刻胶目前可以达到11纳米的分辨率。
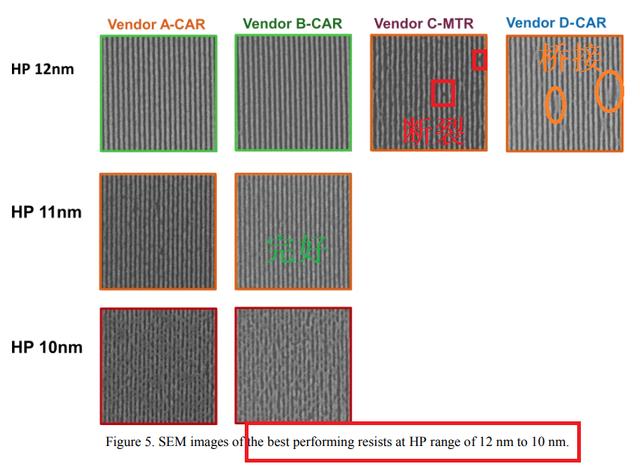
4,最后展示的是一组MOR光刻胶的测试。下图考察不同衬底层对同一款MOR光刻胶曝光分辨率的影响。
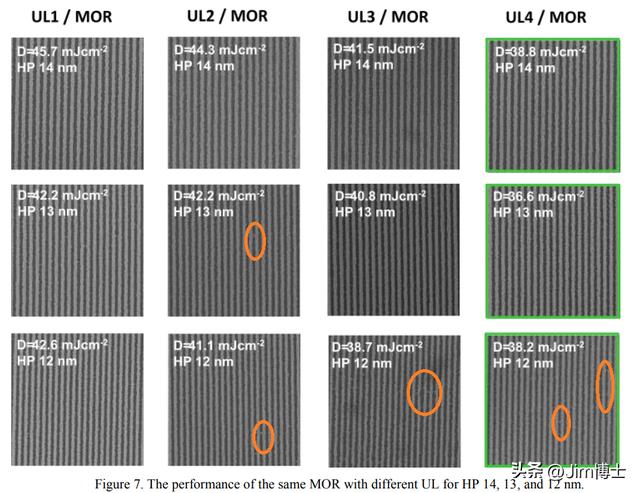
5,通常定义Z-factor去评估光刻机的曝光剂量(Dose-to-size)和线宽偏差(Unbiased LWR)的综合指标。
简单来说,曝光剂量越低越好,线宽偏差越低越好(最少要低于分辨率的十分之一)。
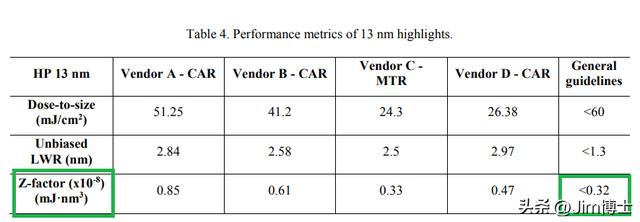
将以上得到的曝光图形进行数据提取,我们就可以得到不同光刻胶的使用区间。从下图我们就可以看到,不同光刻胶、不同厂商的配方都具有不同的特征。比如,虽然MTR光刻胶分辨率最差,但是它的剂量要求是最低的。
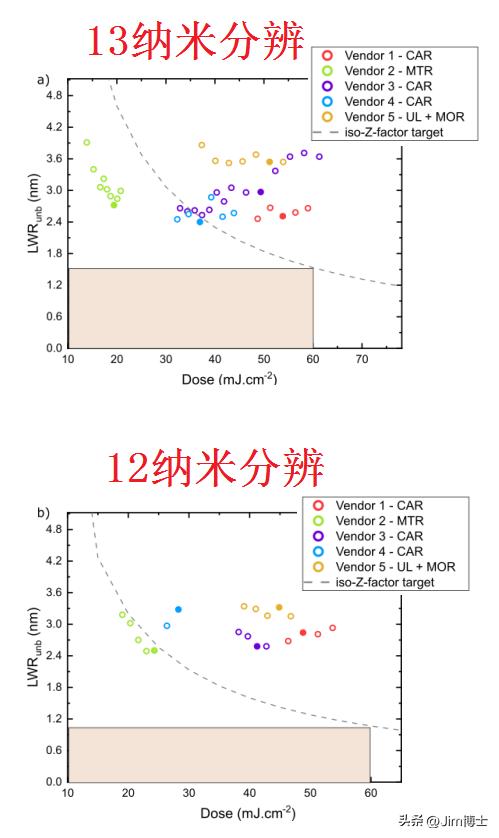
下图是过去3年PSI研究组优化的三种光刻胶MOR、MTR、CAR的最优曲线:
1,MTR的分辨率只能达到13纳米,但是Z-factor最低,适用性最强。
2,CAR的分辨率可以达到11纳米。
3,创新的MOR光刻胶分辨率可以达到10纳米。
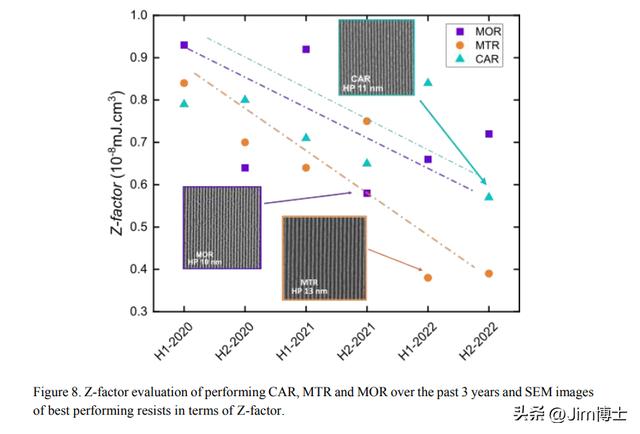
从PSI实验室的最新研究结果看,2纳米光刻胶的性能在过去三年一直在提升,对于满足2纳米芯片制程是非常振奋的结果。
接下来,我们再详细聊聊包括IMEC、Lam、TEL等公司参与的最有希望的2纳米光刻胶--MOR的研究吧。
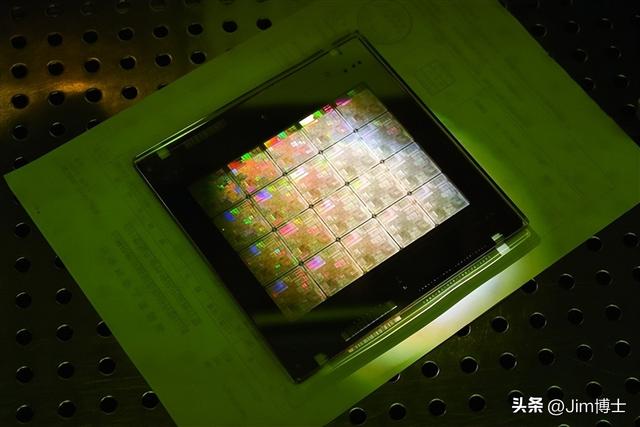
 鲁公网安备37020202000738号
鲁公网安备37020202000738号